新闻资讯
垂直GaN进展
虽然氮化镓(GaN)非常适合作为功率器件材料,但由于难以生产高质量的衬底,直到现在才能够展示其真正的潜力。研究人员正在致力于开发高质量、大直径 GaN 衬底实现新的技术突破。
宽禁带材料有望作为高效率的功率器件材料。特别是GaN、SiC的技术开发和应用取得快速进展。横向 GaN HEMT 已应用于耐压 650V 以下的应用,例如用于 PC 的超小型交流适配器和超小型智能手机充电器,而垂直 SiC 沟槽 MOSFET 已应用于牵引逆变器(主电机驱动)等应用。应用于电动汽车(EV)耐压1200V以上的应用,其社会化应用正在迅速加速。
GaN的潜力超过SiC
如果我们使用 Barriga 指数来比较 MOSFET 和结型 FET (JFET) 等单极功率器件的整体适用性,会发现,当SiC在晶体多晶型为 4H 时,指数为500;而 GaN 则高得多,为930。
Variga 品质因数是由电子迁移率 (μe)、介电常数 (ε) 和介电击穿强度 (Ec) 等物理特性决定的值,GaN 即使在耐压 1200V 的应用中也优于 SiC。这表明它作为功率器件材料具有很高的潜力。如果能够挖掘这一潜力,很有可能通过高频工作使应用设备变得更小、更轻,进一步提高电源效率,提高应用设备的产量。
此外,在使用SiC基功率器件时,一直有人担心可靠性问题,并希望应用GaN作为根本解决方案。SiC晶体有200多种类型,每种都有不同的堆叠结构和构成四面体晶体结构的四个最近的原子的排列,具体而言,主要包括“3C”、“4H”、“6”、“15R”这集中结构。
每种材料都有不同的物理特性,而4H具有高迁移率,专门用于许多功率器件。人们担心的是,当器件在反复加热和冷却的环境中使用时,可能会发生相变,导致器件质量发生变化,从而发生故障和失效。
当然,在使用SiC器件时,我们会通过改进器件结构、质量控制、驱动电路、运行条件、系统配置等措施来解决多态性问题。但可以肯定的是,如果能从材料本身消除引起问题的根本因素,就可以实现对问题的根治。
对于GaN,则有其六方纤锌矿结构和立方闪锌矿两种不同的结构。其中,前者是一种稳定相,用于器件制造;后者也是已知的,但它不是稳定相。这就是为什么在需要高可靠性的应用中希望使用 GaN 代替 SiC。
尽管有这样的背景,但 GaN 器件目前尚未用于处理大量功率的应用(例如电动汽车的牵引逆变器)是有原因的。为了应对高功率,需要将输入端子和控制端子放置在类似于硅基MOSFET和IGBT(绝缘栅双极晶体管)的半导体基板的正面,并将输出端子放置在背,创建一个允许大电流流过的垂直装置。
此时,实现垂直GaN器件需要完全由GaN制成的自支撑衬底,但采用传统的衬底制造技术,会出现许多穿透衬底并阻碍器件工作的位错,不幸的是,GaN衬底质量还没有达到可以满足要求的水平。
此外,为了实现可量产的垂直GaN器件,不仅需要提高衬底质量,还需要增大直径,这会使器件制造成本降低。目前,4 英寸衬底样品可以采用被称为“氨热法”的液相晶体生长技术来制成 ,该技术允许高品质 GaN 晶体的高通量生长。
然而,由于晶体生长的特性,使用氨热法增加基板的直径将被限制在约4英寸。需要新的技术突破来制造直径更大的高质量独立式 GaN 衬底。
垂直GaN进展顺利
垂直型氮化镓(GaN)半导体的研发工作顺利、且正朝着实用化迈进。

图1:结合Na助熔剂法和多点引晶法制造大直径、高质量的GaN籽晶(左)工艺概念图,(右)制造的6英寸GaN籽晶
通过引进一种制造高质量、大直径GaN衬底的技术,该技术结合了大阪大学开发的“Na助熔剂法”和“多点籽晶法”(图1 ),开发了一种可以生长8英寸以上大直径晶体的装置,并生产大直径、缺陷密度为104 /cm2级的GaN籽晶。
Na助熔剂法是日本东北大学山根久典教授于1996年发明的,通过将镓(Ga)和氮(N)溶解到液态钠(Na)中来生长高质量GaN单晶的技术。由于它是液相生长,因此适合生产高质量的晶体。
另一方面,多点籽晶法是一种将许多小型GaN籽晶预先分布在大型蓝宝石衬底上,并在晶体生长过程中使生长的晶体熔合在一起的技术。利用该技术可以生产大直径单晶。结合两种方法的特点,将有可能生产出高质量、大直径的GaN籽晶。此外,Na助熔剂法和多点籽晶法的组合非常兼容,进一步增加直径没有特别的障碍。
垂直型JFET和垂直型MOSFET GaN器件均可耐650V高压、20A电流,预计采用OVPE(Oxide Vapor Phase Epitaxy,氧化物气相外延法)法制成的GaN晶圆,利用该方法制成的GaN器件的ON电阻低于SiC一个数量级。利用OVPE法形成的GaN层虽然可以降低电阻、减少发热,但也存在热阻较高,不易散热的问题。为了发挥OVPE法应用的优势,需要考虑更改器件的设计、或针对封装(Package)开发出新的散热手段,以避免对器件的工作造成不良影响。

图2:采用OVPE法制造的4英寸GaN基板
对于用于电动汽车逆变器等的垂直GaN器件,如果可以降低衬底的电阻,则可以降低器件的导通电阻,从而提高功率效率。通过在晶体中添加硅(Si)或氧(O)等元素可以降低GaN的电阻,但通过OVPE方法,可以生长添加更多的GaN晶体。可以形成电阻值低至10-4 Ωcm 、超过SiC(10-3 Ωcm)、位错密度低至104/cm2的GaN晶体(图3)。
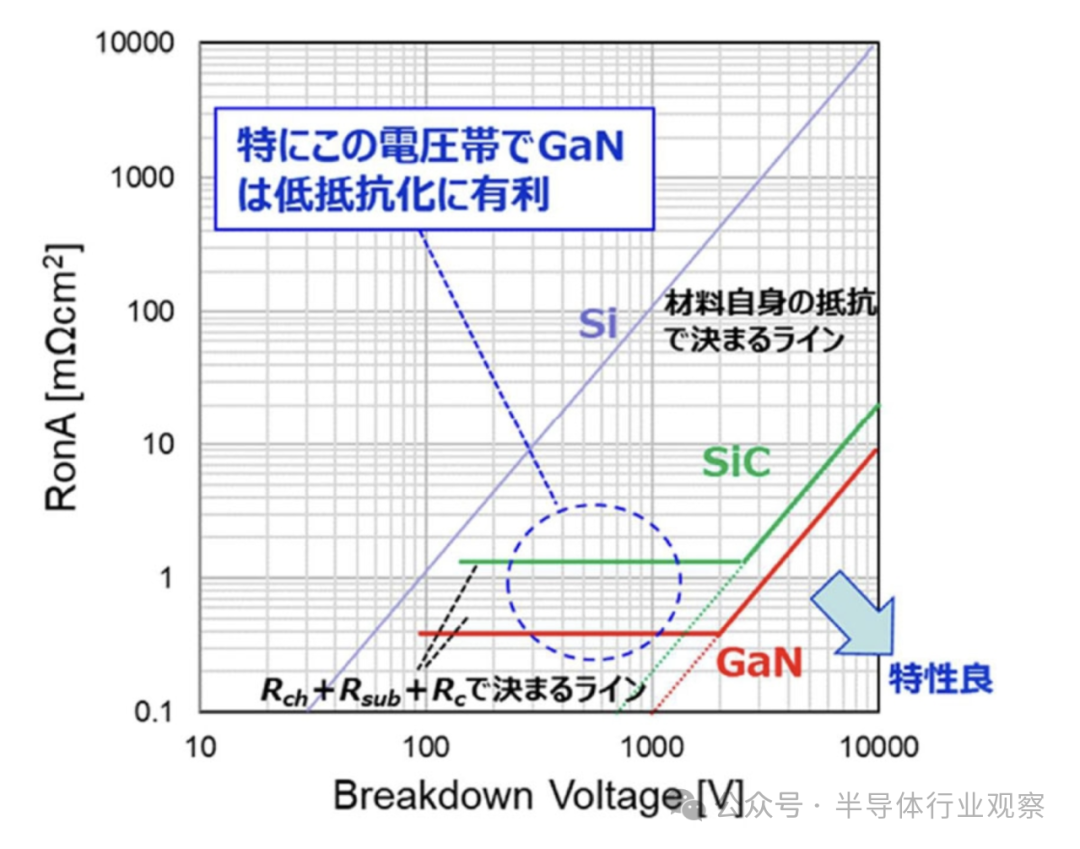
图3:使用OVPE方法制造的超低电阻GaN衬底可以制造比SiC导通电阻更低的器件
下一步:挑战1200V
p-GaN栅(Gate)结构的垂直型JFET特点如下,通过将栅(Gate)周边调整为p-GaN/AlGaN/GaN,使常关闭(Normally-off)和低ON阻值成为了可能(下图4)。电流流经路径的一部分会形成与HEMT通道(Chanel)类似的二维电子气(2D EG)。因此,易于降低ON阻值,更适用于高速工作。通过将此类垂直型JFET应用于高频开关电源线路、电机驱动线路,不仅有利于提升功率,有利于实现电路中零部件的小型化(如线圈等)。此外,还可以利用栅部分的p-GaN来减轻电流阻挡层端部的电场,以降低电流的泄露。
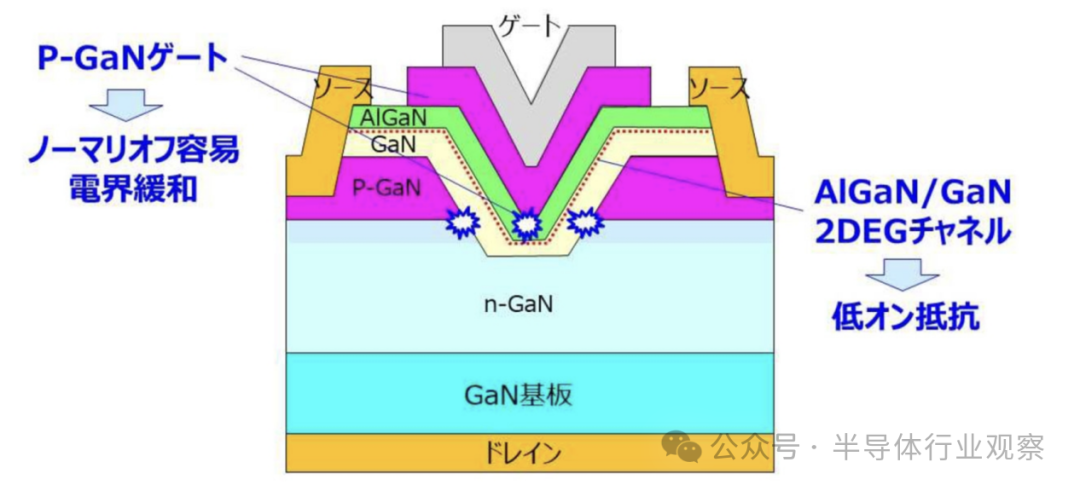
图 4:具有 p-GaN 栅极结构的垂直JFET
由于GaN器件不会像Si、SiC一样可通过热氧化形成高质量的半导体和绝缘层界面,因此很难形成MOSFET结构,仅从这一点就阻碍了GaN器件的生产制程。但是,这种GaN基JFET结构,不需要形成氧化膜。
如今,用于PC方向超小型AC适配器等设备的横向型HEMT结构的GaN功率器件也由同样的工艺制成。此外,不同于栅极由电压驱动的MOSFET,JFET由电流驱动。虽然驱动IC等周边电路的配置不同于Si、SiC,但就这一点而言,有利于横向型器件的技术积累。
松下HD还在研发可耐1200V以上高压的垂直型GaN器件,并讨论了可降低碳(C,此处为随机进入漂移(Drift)层,并补充施体(Donor)的碳)浓度的结晶生长条件,同时还发现了可将碳浓度控制在5×1015/cm3以下的漂移(Drift)层的生长条件,以促进GaN器件的制作。为了今后稳定生产高耐压垂直型GaN器件,还需要研发出可进一步降低碳浓度的结晶生长技术。
沟槽型(Trench)MOSFET基本上采用了与Si基、SiC基垂直型沟槽MOSFET同样的结构(下图4)。工艺如下,在GaN晶圆上同时外延生长出漂移层(n-GaN层)、Body层(pGaN层)、源接触层(Source Contact,n+GaN层)。该工艺不使用离子注入来制作pGaN层,因此制程相对简单。
随后,用干刻蚀加工了接触区域的凹槽(Recess)、栅极沟槽(Gate Trench)。采用了原子层沉积法,以使形成栅极沟槽的栅极绝缘膜的厚度、性质更均一。其MOSFET特性如下,一颗芯片排列有数十万个六角形的MOSFET单元。当需要对应较大的电流时,可通过增加单元数量来满足。
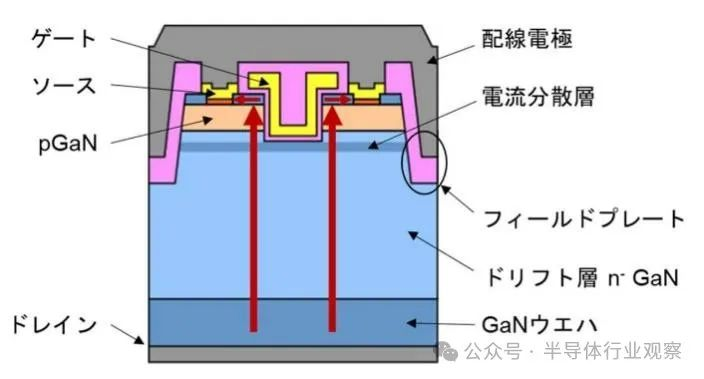
图5:丰田合成研发的垂直型沟槽MOSFET。
MOSFET的特点在于它比JFET更容易实现常关动作(Normally-off),其另一个优势是,可基于更微缩化的技术实现更高的性能。另外,MOSFET需要满足以下应用要求,如在某些应用中(如汽车等),需要满足与传统器件的兼容性,同时采用传统的器件的结构、或采用类似于现有技术的线路布局,而不是单纯的提升性能。
转自:半导体行业观察





